BGA封裝是什么意思_特點(diǎn)是什么_FCBGA封裝與BGA的區(qū)別
數(shù)十年來,芯片封裝技術(shù)一直追隨著IC的發(fā)展而發(fā)展,一代IC就有相應(yīng)一代的封裝技術(shù)相配合。
為了應(yīng)對(duì)集成電路封裝的嚴(yán)格要求與I/O引腳數(shù)快速增加,帶來的功耗增大,在上世紀(jì)90年代,BGA(球柵陣列或焊球陣列)封裝應(yīng)運(yùn)而出。
BGA封裝技術(shù)是一種高密度表面裝配封裝技術(shù):芯片底部引腳成球,排列成格子狀。相比于傳統(tǒng)封裝技術(shù),BGA封裝具有更好的散熱性能、電性能和更小的體積。采用BGA技術(shù)封裝的內(nèi)存,可以使內(nèi)存容量不變的情況下,體積縮小到三分之一。

BGA封裝是一種當(dāng)下芯片制造必不可缺的技術(shù)手段

BGA的封裝根據(jù)焊料球的排布方式可分為交錯(cuò)型、全陣列型、和周邊型。
按封裝形式可分為TBGA、CBGA、FCBGA、和PBGA。
TBGA:
載帶型焊球陣列,是一種較新穎的BGA封裝形式。其焊接時(shí)采用低熔點(diǎn)焊料合金,焊料球材料為高熔點(diǎn)焊料合金,基板是PI多層布線基板。
有以下優(yōu)點(diǎn):
①為達(dá)到焊球與焊盤的對(duì)準(zhǔn)要求,回流焊過程中利用了焊球的自對(duì)準(zhǔn)作用印焊球的表面張力。
②封裝體的柔性載帶能與PCB板的熱匹配性相比較。
③屬經(jīng)濟(jì)型BGA封裝。
④較PBGA,散熱性能更優(yōu)。

CBGA:
陶瓷焊球陣列,是歷史最悠久的的BGA封裝形式。其基板是多層陶瓷,為保護(hù)芯片、引線及焊盤,密封焊料將金屬蓋板焊接在基板上。
有以下優(yōu)點(diǎn):
① 較PBGA,散熱性能更優(yōu)。
② 較PBGA,電絕緣特性好。
③ 較PBGA,封裝密度高。
④ 因其抗?jié)駳庑阅芨撸瑲饷苄院茫庋b組件的長期可靠性高于其他封裝陣列。

FCBGA:
倒裝芯片球柵格陣列,是圖形加速芯片最主要的封裝格式。
有以下優(yōu)點(diǎn):
①解決了電磁干擾與電磁兼容的問題。
②芯片背面直接接觸空氣,散熱效率更高。
③可提高I/O的密度,產(chǎn)生最佳的使用效率,因此使FC-BGA較傳統(tǒng)封裝面積縮小1/3~2/3。
基本上所有圖形加速卡芯片都使用了FC-BGA封裝方式。
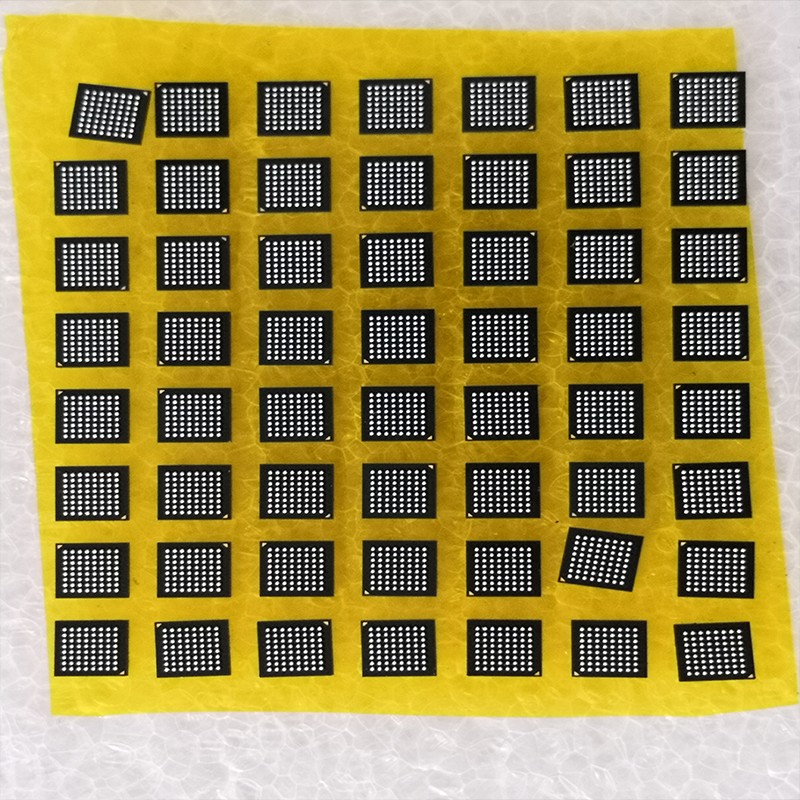
PBGA:
塑料焊球陣列封裝,以塑料環(huán)氧模塑混合物為密封材料,采用BT樹脂/玻璃層壓板為基板,焊球?yàn)楣簿Ш噶?3Sn37Pb或準(zhǔn)共晶焊62Sn36Pb2Ag
有以下優(yōu)點(diǎn):
① 熱匹配性好。
② 電性能好。
③ 熔融焊球的表面張力可以達(dá)到焊球與焊盤的對(duì)準(zhǔn)要求。
④ 成本更低。