選購BGA返修臺我們需要多高的BGA返修成功率?
選購BGA返修臺時我們都會認真比對BGA返修臺的參數,看看廠家賣的設備參數是否符合我們的返修需求。我們首先關心的是bga返修的成功率問題,那么影響bga返修的成功率的因素有哪些呢?
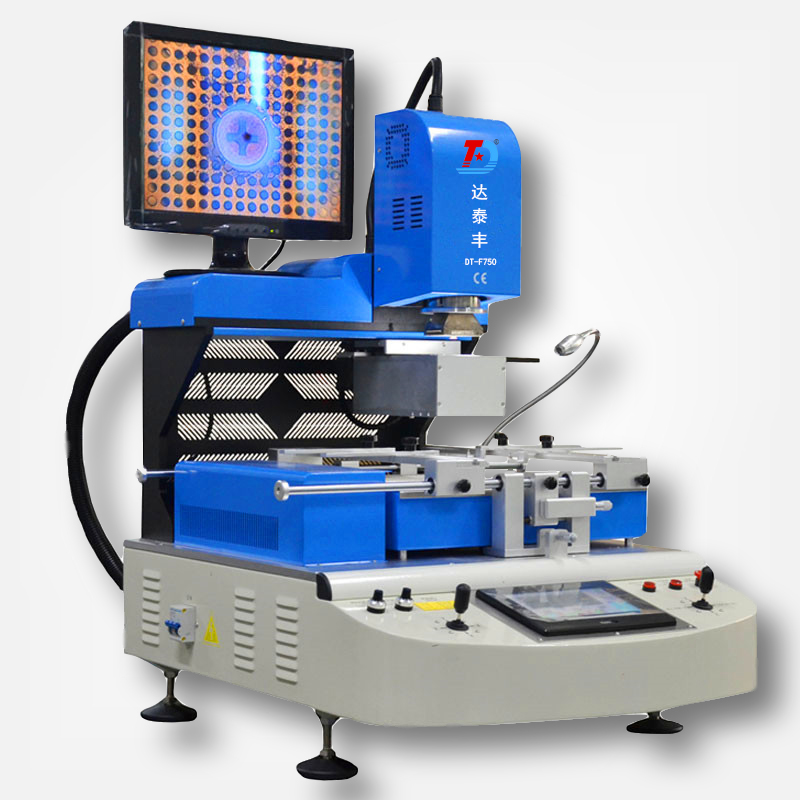
BGA返修成功的主要原因可分為三種:貼裝精度,精準的溫度控制,防止PCB變形以及其他影響。但是,這三個因素很難掌握,因此被列出來共同解決問題。 這是影響BGA返工成功率的主要原因。
第一、焊接bga組件需要確保一定的放置精度,否則會導致氣焊。焊錫球在焊接時具有一定的自動定心作用,允許微小的偏移,在放置過程中,外殼在期間,主體的中心與絲網框架的中心大致重合,可以認為是正確的放置位置。 在不使用光學級bga返修臺的情況下,主觀判斷是否根據bga移動時的手感進行接觸,并且不一定每個人的感覺相同。光學級BGA返修站可以直接查看bga組件是否與焊盤對齊并自動焊接。 目前,國內的bga返修站基本上采用上下熱風和底部紅外預熱方式,因此還需要使用設計合理的空氣噴嘴,以防止熱風在加熱過程中移動bga。
第二、合理,高質量的返工需要適應返工溫度曲線。以掌握溫度和時間,在bga可以承受的范圍內,在標準條件下,鉛含量要少高于260°C,無鉛低于280°C。如果溫度控制不夠且溫度波動較大,則很容易損壞bga組件。 同時,加熱時間不要太長,修復次數也不要太多,否則在高溫條件下會引起bga氧化。長時間會縮短bga的使用壽命。
第三、在焊接或拆卸bga組件時,由于僅將相應的BGA組件單獨加熱,因此很容易造成bga之間的溫差周圍太大,容易變形、損壞。因此,維修bga時必須固定電路板和bga的位置,一般bga返修臺將使用下部空氣噴嘴支撐PCB板,下部的風能起一定的支撐作用。如果使用氣槍進行拆焊,則需要固定電路板以防止發熱。 變形直接導致PCB損壞。同時,有必要對整個PCB板進行預熱以減小溫度差,從而可以有效地防止變形。
選購BGA返修臺我們需要多高的BGA返修成功率?以上就是我提供的參考意見,如果還有其他的疑問,歡迎咨詢達泰豐科技,我們安排更專業的銷售的工程師為您排憂解難,提供一個完美的選購BGA返修臺的方案。
