提高手工焊接BGA返修良率的方法與技巧
BGA返修行業(yè)是一個對動手能力要求非常高的一個行業(yè)。BGA芯片的返修通常有2種方式,即BGA返修臺和手工熱風槍焊接。一般工廠或者維修店會選擇BGA返修臺,因為焊接成功率高而且操作簡單,對操作人員基本上沒有要求,一鍵式操作,適合批量返修。第二種手工焊接,手工焊接對技術要求較高,尤其是大的BGA芯片,手工焊接如何提升bga返修良率呢?
提高手工焊接BGA返修良率的方法
能手工焊接BGA,確實不錯,因為現(xiàn)在的BGA封裝的芯片越來越多,這個關得過。很多人還是比較怕手工焊接bga,主要是這種封裝的芯片都很貴,心里沒底。其實只有多嘗試才能成功。
需要注意的地方:
(一)拆下BGA主控后,一定要補錫,因為拆了以后有些脫錫,主控和主板上都要補,可以把錫漿抹上去拿烙鐵拖,這樣保證接觸良好;
(二)吹的時候溫度不要太高,280℃左右都可以,風槍不要離植錫板太近,要晃動風槍均勻吹,這樣錫點不會亂跑;
(三)次上錫植的錫點不一定很均勻,可手動刮平,有不平的地方補錫再吹;
(四)植好BGA后可以在BGA打上助焊劑,拿風槍吹勻使BGA主控上焊點勻潤;BGA植上主板的時候也要多打助焊劑。
一、可以降低熔點;
二、可以讓BGA跟著助焊劑與主板上錫點連接好;感覺吹上后可以拿鑷子輕輕左右上下點一下BGA邊緣,以保證接觸良好。
這個辦法對小的BGA芯片可以,但對北橋之類的大芯片,成功率就低很多。拆焊大的BGA芯片時,建議使用達泰豐BGA返修臺,這樣能提升BGA返修良率。
提高手工焊接BGA返修良率的技巧
1、 用新的芯片必須保證BGA芯片的錫球都是飽滿的
如下圖,錫球大了導致短路,錫球小了導致虛焊。所以全新的BGA芯片,很容易焊接。
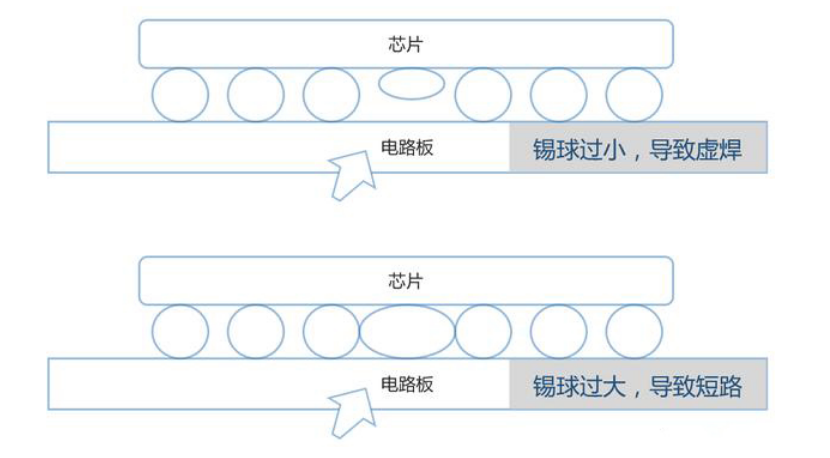
拆下來的BGA芯片,如果底部焊盤不均勻,需要重新植錫,確保每個錫球都差不多大。(植錫=種植錫球,也可以手工操作)
2、 電路板焊盤要平整
如下圖左邊的電路板上的焊盤,原本是沒有焊錫的。SMT的時候,要先通過鋼網印刷一層厚度均勻的錫膏。但是手工更換BGA的時候,電路板上會有殘留的焊錫(下圖右邊),如果焊錫不均勻,也會跟錫球不均勻一樣,會短路或者虛焊。

有兩種方法可以把焊盤搞均勻:
一、用刀頭烙鐵把焊盤刮一遍,勻速、同樣力度,基本上能保證焊盤殘余焊錫都一樣多,這個比較考手藝。二、用吸錫線,把焊盤上的殘留焊錫都吸走,這樣焊盤就平整了,這個操作要簡單一些。

3、加適量助焊劑
在電路板BGA焊盤上均勻的抹一層助焊劑,有助于提升焊錫流動性。SMT貼片印刷的錫膏里自帶助焊劑,BGA芯片的錫球里沒有助焊劑。所以手工焊接的時候需要補一些助焊劑。
4、戳一戳,動一動
把新的BGA芯片擺在抹了助焊劑的焊盤上,用熱風槍把焊錫吹熔化之后,可以用鑷子輕輕的戳一下BGA芯片的四個角,每次不超過0.2mm。芯片略微移位之后,在焊錫的張力作用下,能夠自動回到原來的位置上。這個動作能夠把芯片下面的沒有接觸到的錫球重新接觸起來;略有短路的錫球在助焊劑的幫助下,也能夠分開。能夠顯著的提高BGA焊接成功率。
不過要注意的是,手上一定要輕、動大了或者焊盤錯位就廢了,移動量不能超過焊盤間距的一半。手抖的硬件工程師要慎用這一招。
