高精度BGA拆焊臺和普通的BGA拆焊臺區別?
高精度BGA拆焊臺和普通的BGA拆焊臺功能基本上差不多。高精度BGA拆焊臺相比于普通BGA拆焊臺優點是能夠返修精度超高的BGA芯片,而普通BGA拆焊臺無法完成高精度BGA返修的主要原因是溫度達不到返修密間距BGA芯片的溫度設置要求。推薦達泰豐科技BGA拆焊臺DTF750,這個就是高精度BGA拆焊臺相比普通BGA拆焊臺最大的優點。高精度BGA拆焊臺加熱時相鄰BGA溫差正常在183℃左右,這么大的溫差普通BGA拆焊臺是無法達到的。
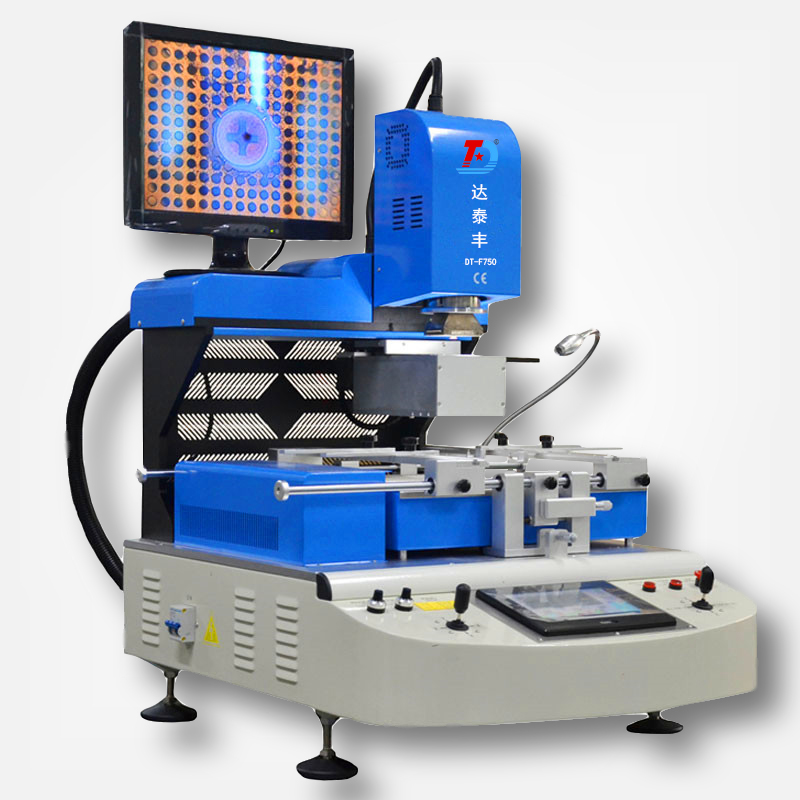
高精度BGA拆焊臺相比普通BGA拆焊臺溫度設置更精準方便,高精度BGA拆焊臺焊接BGA,最大的優點是溫度曲線能夠精準設置,BGA拆焊臺在經過190℃的預熱期后,會自動升溫到250℃,再遞增到300℃,錫膏才能充分焊好;完成后遞減式降溫,再到冷卻散熱。溫度曲線設置還需要根據芯片是否含鉛、芯片尺寸、錫膏牌子的不同,各階段的溫度和延續時間都不盡相同。
對于高精度BGA芯片的返修需要根據芯片的類型、溫度程序等不同進行設置。熱風加熱是利用空氣傳熱的原理,使用高精度可控型發熱控件,調整風量、風速達到均勻可控的加熱的目的,焊接時BGA芯片本體因傳熱的原因,傳到BGA芯片錫珠部分的溫度會比熱風出口處相差一定的溫度。高精度BGA拆焊臺在設置溫度加熱時,要把以上要素考慮進去,同時我們也要對錫珠的性能了解,進行區分溫度段設置。
當我們需要對新的BGA芯片進行返修,在不了解其溫度耐性的情況下,我們需要對高精度BGA拆焊臺設定一個值,然后對整個加熱過程進行監控,在溫度升到200度以上的時候,觀察錫球的融化程度,并用鑷子試下看是否能夠移動。BGA芯片錫球全融化時會明顯觀察到BGA芯片向下陷,此時再恒溫給芯片加熱10-20秒,即完成了溫度的設置。而普通BGA拆焊臺沒有恒溫階段設置,容易造成損壞。
如果返修高精度密間距的BGA芯片必須使用高精度BGA拆焊臺才能完成,其中有兩點原因:
1、普通BGA拆焊臺一般是二溫區的它無法對無鉛芯片進行拆焊。
2、高精度BGA拆焊臺相比于普通BGA拆焊臺優勢在于具有三部份發熱系統獨立控溫,能夠根據不同芯片間距來組合,從而達到最佳的溫度加熱效果。還有高精度BGA拆焊臺設計和用料上面相對于普通BGA拆焊臺要好一些,所以價格也要貴一些。
